— 產品(pǐn)分類 —
化學氣相沉積技術的分類(lèi)和簡介
發布時間:
2025-01-14
化(huà)學氣相沉積技術有多種分類方法。按激發方式可分為熱化學氣(qì)相沉積(TCVD)、等離(lí)子體化學氣相沉積(PCVD)激光(激發)化學氣相沉積等。按反應室壓力可分為常壓化學氣相沉積、低壓(yā)化學氣相沉積等。按反應溫度(dù)的相(xiàng)對高低可分為高溫化學氣相沉積、中(zhōng)溫化學氣相(xiàng)沉積、低溫化學(xué)氣相沉積。有人(rén)把常壓化學(xué)氣相沉積稱為常規化學氣相沉積,而(ér)把低壓化學(xué)氣相沉積、等離子體化學氣相沉積、激光化學氣相沉(chén)積等列(liè)為“非常規”化學氣相沉積。
化學(xué)氣相沉積技術有多種分類方法。按激發方式可(kě)分為熱化學氣(qì)相(xiàng)沉積(TCVD)、等離子體化學(xué)氣相沉積(PCVD)激光(激發)化學氣相沉積(jī)等。按(àn)反應室壓力可分(fèn)為常壓化學氣相沉積、低壓(yā)化學氣相沉積等。按反應(yīng)溫度的相對高低可分為高溫(wēn)化學氣相沉積、中溫化學氣相沉積、低溫化學(xué)氣相沉(chén)積。有人把(bǎ)常(cháng)壓化學氣相沉積稱為常規化學氣相沉積,而把低壓化學氣相(xiàng)沉積、等離子體化學氣相(xiàng)沉積、激光化學(xué)氣相沉積等列為“非常規”化學氣相沉積。也有按源(yuán)物質歸類,如金屬有(yǒu)機化合物(wù)化學氣相沉積、氯化物化學氣相沉積、氫化物化學氣相沉積等。除了上述分類方法外,還經常按目前重(chóng)要的、以主特征進(jìn)行綜合分類即分為熱激發化學(xué)氣相沉積、低壓化學氣(qì)相沉積、等離子體化學氣相沉積、激光(誘導)化學氣相沉(chén)積、金屬有機化合物化學氣相沉積等。下麵就按這個分類(lèi)方法分別介紹這幾類化學氣相沉積技術的概況。
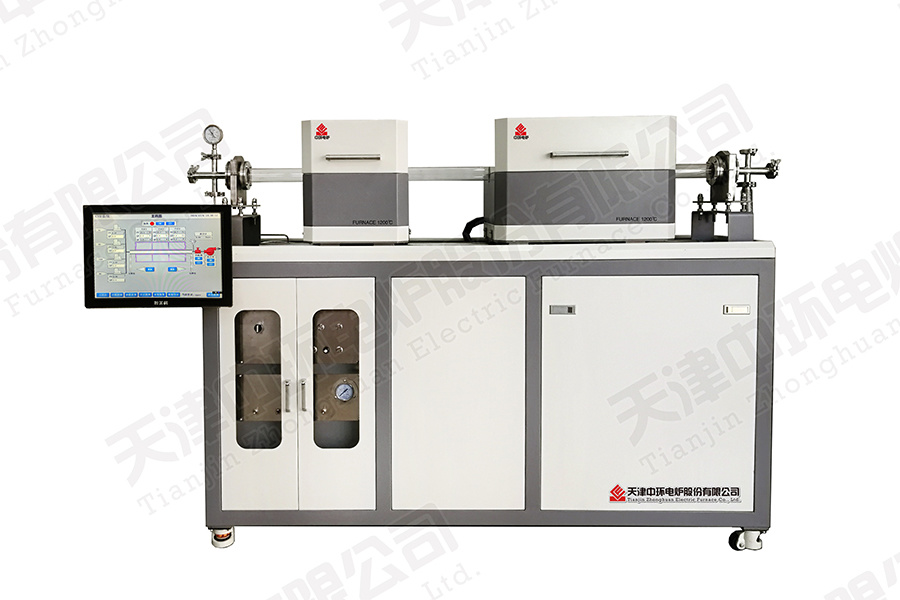
01
熱化學氣相沉積(TCVD)
熱化(huà)學氣相沉(chén)積(TCVD)法的原理是,利用揮發性(xìng)的金屬鹵化物和金(jīn)屬的有機化合物等,在高溫下(xià)發生氣相化學反應,包(bāo)括熱分解、氫還原、氧化、置換反應等,在基板上沉積所需要的氮化物、氧(yǎng)化(huà)物、碳化物、矽化物、高(gāo)熔點金屬、金屬、半導體等薄膜。在(zài)反應過程中,以氣體形式提供構成薄(báo)膜的原料,反應尾氣由抽(chōu)氣係統排出。通過熱能(輻射、傳(chuán)導、感應加熱等)除加熱基板到適當溫度(dù)之外,還對氣(qì)體分子進行激發、分(fèn)解,促進其反應。分解生成(chéng)物或(huò)反應產物沉(chén)積在基體(tǐ)表麵形成薄(báo)膜。
熱化學氣相沉積按其化學反應形式又可分(fèn)為三類:化學輸運法、熱解法、合成反應法。其中:化學(xué)輸運法雖然能製備薄膜,但一般用於塊(kuài)狀晶(jīng)基(jī)體生長;熱解法通常用於沉積薄膜;合成反應法則兩種情況都用。熱化學氣相沉積應用於半導基體和(hé)其他材料。廣(guǎng)泛應用的化學氣相沉積技術如金屬有(yǒu)機化學氣(qì)相沉積、氫化物化學氣相沉積(jī)等都(dōu)屬於這個範圍。
02
低壓化學氣相沉積(LPCVD)
低壓化學氣相沉積(LPCVD)是在常壓化學氣相沉積的基礎上,為提高膜層質量,改善膜厚與電阻率等特性參數分布的均勻性,提高生產(chǎn)效率等而發展起來的。低壓(yā)化學氣相沉積的主要特征有:
(1)低壓化學氣相沉積的壓力範圍一般在0.0001x10的(de)4次方~4x10的4次方Pa之間。由於低壓下分子平均自由(yóu)程增加(jiā),因而加快了氣態(tài)分子的輸運過程,反應物質在工件表麵的擴散係數增大,使薄膜均勻性得到改善。對於表麵擴散動力學(xué)控製(zhì)的外延生長,可增大(dà)外(wài)延層的均勻性,這在大麵積大規模外(wài)延生長(zhǎng)中(例如,大規模矽器件工藝中的介質膜外延生長)是(shì)必要的(de)。但是對(duì)於(yú)由質量輸(shū)送控製的外延生長,上述(shù)效應並不明(míng)顯。
(2)低壓外延生長,對(duì)設備要求較高,必須有精確的壓(yā)力控製係統,反(fǎn)應器采用擴散(sàn)爐型,溫度容易(yì)控製。在低壓(yā)下更容易實現基片的均勻(yún)加熱,特別是可以大批(pī)量地裝載基片,從而可靠性及生產效率大幅度提高。低壓外延(yán)有時是必須采用的手段(duàn),如當化學反應對壓力敏感時,常壓下不易進行的反應,在低壓下變得容易進行。低壓外延有時會影響分凝係數。
(3)由於Si基片垂直裝載,即(jí)使矽圓片直(zhí)徑變大,也不(bú)影響其處理能力隨著基片(piàn)尺寸的進一步增大(dà),為了抑製顆粒的產生,可采用縱型反應器。
03
等離子體化學氣相沉積(PCVD)
PCVD法按加給反應室電力的(de)方法可分為以下幾類:
(1)直流法。利用(yòng)直流電(diàn)等離子體的激活化(huà)學反應進(jìn)行氣相沉(chén)積的技術稱為直流等離子體化學氣相沉積(DCPCVD)。它在陰極側成膜,此膜會受到陽極附近的空間電荷所產生的強磁場的嚴重影響。用稀釋反應氣體時膜中會進入氬,為(wéi)避免這種情況,將(jiāng)電位等於陰極側基材電(diàn)位的簾棚(péng)放置於陰極前麵,這樣可以得到(dào)優質薄膜。
(2)射頻(pín)法。利用(yòng)射頻離子體激活化學反應(yīng)進行氣相沉積的技術稱為射頻(pín)等離子體化(huà)學氣相(xiàng)沉積(RFPCVD)。供(gòng)應射頻功率的耦合方式大致分(fèn)為電感耦合方(fāng)式和電容耦(ǒu)合方式。在放電中(zhōng),電極不發生(shēng)腐蝕,無雜質汙染(rǎn),需要調整(zhěng)基材位(wèi)置和外(wài)部電極位置。也采用把電極裝入內部的耦合(hé)方式,特別是平行平板方式(電容(róng)耦合)在電穩(wěn)定性和電功率效率上均顯示優異性(xìng)能,得到廣泛應用,反(fǎn)應室壓力保持(chí)在0.13Pa左右,基材與(yǔ)離子體之間加有偏壓,誘導沉積在基材表麵。射頻法可(kě)用來沉積絕緣膜。
(3)微波法。用微波等離子體激活化學反應進行氣相沉積的技術,稱為微波等離子體化學氣相沉積(MWPCVD)。由於微波等離子體技術的發展,獲得各(gè)種氣體壓(yā)力下的微波等離子體已(yǐ)不成問題。現在有多種MWPCVD裝置。例如,用一個低壓化學氣相沉(chén)積反應管,其上交叉安置共振腔及與之匹配的微波(bō)發射器,以 2.45GHz的微波,通過矩形波導人(rén),使化學(xué)氣相學積反應管中被共振腔包圍的氣體形成等離子體,並(bìng)能(néng)達到很(hěn)高(gāo)的電(diàn)離度和(hé)離解度,再經軸對(duì)稱磁場打(dǎ)到基材上。微波發射功(gōng)率通常在幾百(bǎi)瓦至1kW以上,這可根據托盤溫度和生長過程(chéng)滿足質量輸運限速步驟等條件決定。這項技術具有下列(liè)優點:可進一步降(jiàng)低基材溫度,減少因高溫生(shēng)長造(zào)成的(de)位錯缺陷、組分或雜質的互擴散;②避免了電極汙染:③薄膜受等離子體的破壞小:4更適合於低熔點和高溫下不穩定(dìng)化(huà)公物薄膜的製備:⑤由於其頻率很高,因此對係統內(nèi)氣體壓力的控製可以大大放寬;⑥由於其頻率很高,在合成金剛石時更容易獲得晶態金剛石(shí)。除了上述的直流法、射頻法、微波法三類外,還(hái)有同時加電場和(hé)磁場的方法為在磁場使(shǐ)用下增加(jiā)電子壽(shòu)命,有效維(wéi)持放電,有時需要在特別(bié)低壓(yā)條件下進行放電。
PCVD最早(zǎo)是利用有機矽化合物在半導體上沉(chén)積SiO2,後來在半導體工業上獲得了廣泛的應用(yòng),如沉積(jī)Si3N4、 Si、SiC、磷矽玻璃等。目前(qián),PCVD 已不僅用於半導基體(tǐ),還用於金屬、陶瓷(cí)、玻璃等基材上,作保護膜、強化膜、修飾膜、功能膜。PCVD另兩個重要應用是製備聚合物膜以及(jí)金剛(gāng)石、立方化硼等薄膜(mó),展現了良好的發展前景。
PCVD 技(jì)術與 TCVD 技術相(xiàng)比,具(jù)有以下特(tè)征。
(1)可以在更低的溫度下成膜。如沉積TC、Ti(CN)、TiN 和 Si3N4的反應溫度可分別(bié)在700K、550K、520K和530K下進行,而用常規化(huà)學氣相(xiàng)沉積則分別要在1200K、1000K、900K和1200K以上(shàng)。PCVD之所以能夠在較低溫度下進行,是因(yīn)為在等離子體化學氣相沉積的情況下,不(bú)是靠(kào)氣體的溫度使氣體(tǐ)激發離解(jiě),而是等離子體中的電子(zǐ)的能量。大多數PCVD都是使用非平衡等離子體電子溫度很高,而氣體溫度較低,甚至可(kě)以接近室溫。在輝光放電(diàn)的範圍,所(suǒ)形(xíng)成的等離(lí)子體的電子溫度在1~10eV,足(zú)以打斷氣體原子間的化學鍵,實現氣體(tǐ)的激發和離解,形成具有很高化(huà)學(xué)活性的離子(zǐ)和各(gè)種化學基(jī)團(原子團)。降低化學氣相沉積反應的溫度在技術應(yīng)用上具有十分重要的(de)意義,很多襯底材料,如鋁或有機聚合物,如溫度過高,前者就會熔化而(ér)後者可能分解或變質(zhì)、脫氣。有些金屬和合金,在溫度較高時則可(kě)能發生相變,結構變化所引起的體積變化造成的應力可能使膜層開裂或(huò)剝落。
在半導體工藝中所用的摻雜元素,如硼和磷(lín),在溫度超過 800℃時就會發生顯著的擴散,使器件的性能變壞。采用等離子體可以很容易地(dì)在這些摻雜的襯底上沉積各(gè)種膜層。
(2)可(kě)以(yǐ)大大減小由於薄膜和襯底熱膨脹係數不匹配(pèi)所造成的內應力。
(3)即使對於采(cǎi)用熱過程難以成膜的反應速率(lǜ)極(jí)慢(màn)的物質(zhì),也可以采用PCVD技術在一定的沉積速率下成膜。這是(shì)因為在多數PCVD的情況下(輝光放電)所用(yòng)的壓力(lì)較低,增強了反應氣體和生成氣體產物穿過邊界層在平流(liú)層(céng)和襯(chèn)底(dǐ)表麵之間的質量輸運,而且使膜(mó)厚均勻性也得到(dào)改善。低沉積溫度有利於得到非晶態和(hé)微晶薄膜,而非晶態或(huò)微晶薄膜往往具(jù)有獨特的優異性能。此外,對於熱分解溫度不同的物質,也可以按不同的組成比合成。PCVD也有不足之處。其一是在等離子體中,電子的能(néng)量分布範圍很寬,除電子碰撞外,在離子碰(pèng)撞作用和放電時產生的射線的作用下也(yě)可產生新粒子(zǐ),因此 PCVD反(fǎn)應未必是選擇性的,很可能同時存在幾種化學反應,使反應產物(wù)控製變得困難,反應機理也往往難於解釋。因此,采用PCVD 難於得到純淨的物(wù)質由於沉積溫度較低,反應產生的副產物氣體和其他氣體的解吸進行不徹底,往往殘留在沉積的薄膜中(特別是氫)。而在(zài)化合物(如碳化(huà)物(wù)、氮化物、氧化物、矽化物(wù)等)沉積的情況下,很難(nán)保證準確的化學計量比。一般情況下,這是不利的,將改變其物理、化學性質,降低抗腐蝕性(xìng)和抗輻射能力。其二,PCVD 往往傾向於(yú)在薄膜中造成壓應力。對於(yú)在半導體工藝中應用的超薄膜來講,應力還不至於造成太大(dà)的問題。對冶金塗層來講,壓應力有時反而是有利的。但塗層較厚時應力有可能(néng)造成塗層的開裂和剝落。PCVD另一缺(quē)點是對某些脆弱襯底如(rú)半導體工藝(yì)中用的Ⅲ-V族和Ⅱ-Ⅵ族化合物半導體材料,容(róng)易造成離子轟擊(jī)損傷(特別是當離(lí)子(zǐ)能量超過20eV時)。此外,等離(lí)子體可能和沉積中的塗層(céng)表麵有強烈的作用,這意味著(zhe)薄膜沉積速率及薄膜的性質依賴於等離子體的均勻性。最後,PCVD裝置一般來講較複雜,價格也較高。
總的說來,PCVD的優越性是主要的(de),現在(zài)正(zhèng)獲得(dé)越來越廣泛的應用。
04
金屬有機化合物化學氣相沉積(MOCVD)
金屬有機化合物是一類含有(yǒu)碳-金屬鍵的物質。它要(yào)適用於MOCVD法,應(yīng)具有易於合成和(hé)提純,在室溫下是液體並有適當的蒸氣壓、較低(dī)的熱分解溫度(dù)對沉積薄膜沾汙小和毒性小等特點。現以生長亞-V族化合物為例。載氣高純氫通過裝有Ⅲ族元素(sù)有機(jī)化合物的鼓泡瓶攜帶其蒸氣與用(yòng)高純氫稀釋的V族元素氫化物分別導入反應室,襯底放在高頻加熱的石墨基座上,被加熱的襯底對金屬有機物的熱(rè)分(fèn)解具有催化效應,並在其上生成外延層,這是在遠離熱平衡狀態下進行(háng)的。在較(jiào)寬的溫度(dù)範圍內,生長速率與溫度無關,而隻與到達表麵源物質(zhì)量有關。
MOCVD 技術所用的設備包括:溫度精確控製係統、壓力精確控製(zhì)係統、氣體流量精確控製係統、高純載氣處理係統(tǒng)、尾氣處理係統等(děng)。為了提(tí)高異質界麵的(de)清晰度,在反應室(shì)前通常設有一個高速、無死(sǐ)區的多(duō)通道氣體轉換閥;為了使氣體轉換順利進行,一般設有反(fǎn)應氣路和輔助氣路,兩者氣體壓力要保持相等。
根據MOCVD生(shēng)長壓力的不同,又分為常壓MOCVD和低壓MOCVD。將MOCVD與分(fèn)子(zǐ)束外延(MBE)技術結合,發展出金屬有機化合物分子束外延(MOMBE)和化學束外(wài)延(CBE)等技術。
與(yǔ)常(cháng)規化學氣相沉積相比,MOCVD的優(yōu)點是:沉積溫度低:②能沉積(jī)單(dān)品、多晶(jīng)、非晶的膜層(céng)和超薄層、原子層薄膜;③可以大(dà)規模、低成本製備複雜組分的薄膜和化合物半導基體材(cái)料:④)可以在不同基材表麵沉積:⑤每一(yī)種或增加一種(zhǒng)MO源可以增加沉(chén)積材料中的一種組分或一種化合物,使用兩種或更多(duō)MO源可以沉積二元(yuán)或(huò)多元、二層或多層的表麵材料,工藝的通用性較廣MOCVD的缺點是(shì):沉積速(sù)度較慢,僅適宜於沉積微米級的表麵層:原料(liào)的毒性較大,設備的密封性、可靠性要好,並謹慎(shèn)管理和操作。
05
激光激發化學氣相沉積(LCVD)
LCVD與(yǔ)常規化學氣相沉積(jī)相比,可以大大降低基(jī)材的溫度,防止基材中雜質分布(bù)受到破壞,在(zài)不能承受高溫的基(jī)材上合成(chéng)薄膜。例如,用TCVD製備SO2、S3N4、AIN 薄膜時基材(cái)需加熱到(dào) 800~1200℃,而用LCVD 則需(xū) 380~450℃。LCVD與PCVD相比,可以避免高(gāo)能粒子輻照在薄(báo)膜中造成的損(sǔn)傷。由於給定的分子隻吸收特定波長的光子,因(yīn)此,光子能量(liàng)的選擇決定了什麽樣的化學鍵被打斷,這樣使薄膜的純度和結構就能得到較好的控製。
下(xià)一(yī)頁
相關新聞



